- 品牌
- 英飞凌
- 型号
- IGBT
这部分在定义当中没有被提及的原因在于它实际上是个npnp的寄生晶闸管结构,这种结构对IGBT来说是个不希望存在的结构,因为寄生晶闸管在一定的条件下会发生闩锁,让IGBT失去栅控能力,这样IGBT将无法自行关断,从而导致IGBT的损坏。具体原理在这里暂时不讲,后续再为大家更新。2、IGBT和BJT、MOSFET之间的因果故事BJT出现在MOSFET之前,而MOSFET出现在IGBT之前,所以我们从中间者MOSFET的出现来阐述三者的因果故事。MOSFET的出现可以追溯到20世纪30年代初。德国科学家Lilienfeld于1930年提出的场效应晶体管概念吸引了许多该领域科学家的兴趣,贝尔实验室的Bardeem和Brattain在1947年的一次场效应管发明尝试中,意外发明了电接触双极晶体管(BJT)。两年后,同样来自贝尔实验室的Shockley用少子注入理论阐明了BJT的工作原理,并提出了可实用化的结型晶体管概念。1960年,埃及科学家Attala及韩裔科学家Kahng在用二氧化硅改善BJT性能的过程中意外发明了MOSFET场效应晶体管,此后MOSFET正式进入功率半导体行业,并逐渐成为其中一大主力。发展到现在,MOSFET主要应用于中小功率场合如电脑功率电源、家用电器等。 Infineon的IGBT模块常用的电压为:600V,1200V,1700V。四川进口英飞凌infineonIGBT模块服务电话
英飞凌infineonIGBT模块
有无缓冲区决定了IGBT具有不同特性。有N*缓冲区的IGBT称为非对称型IGBT,也称穿通型IGBT。它具有正向压降小、犬断时间短、关断时尾部电流小等优点,但其反向阻断能力相对较弱。无N-缓冲区的IGBT称为对称型IGBT,也称非穿通型IGBT。它具有较强的正反向阻断能力,但它的其他特性却不及非对称型IGBT。如图2-42(b)所示的简化等效电路表明,IGBT是由GTR与MOSFET组成的达林顿结构,该结构中的部分是MOSFET驱动,另一部分是厚基区PNP型晶体管。五、IBGT的工作原理简单来说,IGBT相当于一个由MOSFET驱动的厚基区PNP型晶体管,它的简化等效电路如图2-42(b)所示,图中的RN为PNP晶体管基区内的调制电阻。从该等效电路可以清楚地看出,IGBT是用晶体管和MOSFET组成的达林顿结构的复合器件。冈为图中的晶体管为PNP型晶体管,MOSFET为N沟道场效应晶体管,所以这种结构的IGBT称为N沟道IIGBT,其符号为N-IGBT。类似地还有P沟道IGBT,即P-IGBT。IGBT的电气图形符号如图2-42(c)所示。IGBT是—种场控器件,它的开通和关断由栅极和发射极间电压UGE决定,当栅射电压UCE为正且大于开启电压UCE(th)时,MOSFET内形成沟道并为PNP型晶体管提供基极电流进而使IGBT导通,此时,从P+区注入N-的空穴。 陕西英飞凌infineonIGBT模块代理商各代的IGBT芯片都有自己适合工作的开关频率,不能乱选型,IGBT频率与型号的后缀相关。
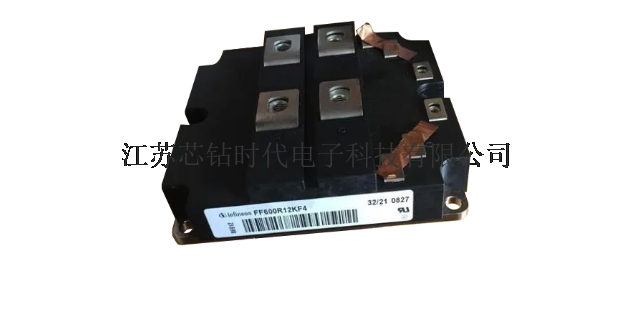
1979年,MOS栅功率开关器件作为IGBT概念的先驱即已被介绍到世间。这种器件表现为一个类晶闸管的结构(P-N-P-N四层组成),其特点是通过强碱湿法刻蚀工艺形成了V形槽栅。80年代初期,用于功率MOSFET制造技术的DMOS(双扩散形成的金属-氧化物-半导体)工艺被采用到IGBT中来。[2]在那个时候,硅芯片的结构是一种较厚的NPT(非穿通)型设计。后来,通过采用PT(穿通)型结构的方法得到了在参数折衷方面的一个明显改进,这是随着硅片上外延的技术进步,以及采用对应给定阻断电压所设计的n+缓冲层而进展的[3]。几年当中,这种在采用PT设计的外延片上制备的DMOS平面栅结构,其设计规则从5微米先进到3微米。90年代中期,沟槽栅结构又返回到一种新概念的IGBT,它是采用从大规模集成(LSI)工艺借鉴来的硅干法刻蚀技术实现的新刻蚀工艺,但仍然是穿通(PT)型芯片结构。[4]在这种沟槽结构中,实现了在通态电压和关断时间之间折衷的更重要的改进。硅芯片的重直结构也得到了急剧的转变,先是采用非穿通(NPT)结构,继而变化成弱穿通(LPT)结构,这就使安全工作区(SOA)得到同表面栅结构演变类似的改善。这次从穿通(PT)型技术先进到非穿通(NPT)型技术,是基本的,也是很重大的概念变化。这就是:穿通。
PT)技术会有比较高的载流子注入系数,而由于它要求对少数载流子寿命进行控制致使其输运效率变坏。另一方面,非穿通(NPT)技术则是基于不对少子寿命进行杀伤而有很好的输运效率,不过其载流子注入系数却比较低。进而言之,非穿通(NPT)技术又被软穿通(LPT)技术所代替,它类似于某些人所谓的"软穿通"(SPT)或"电场截止"(FS)型技术,这使得"成本-性能"的综合效果得到进一步改善。1996年,CSTBT(载流子储存的沟槽栅双极晶体管)使第5代IGBT模块得以实现[6],它采用了弱穿通(LPT)芯片结构,又采用了更先进的宽元胞间距的设计。包括一种"反向阻断型"(逆阻型)功能或一种"反向导通型"(逆导型)功能的IGBT器件的新概念正在进行研究,以求得进一步优化。IGBT功率模块采用IC驱动,各种驱动保护电路,高性能IGBT芯片,新型封装技术,从复合功率模块PIM发展到智能功率模块IPM、电力电子积木PEBB、电力模块IPEM。PIM向高压大电流发展,其产品水平为1200-1800A/1800-3300V,IPM除用于变频调速外,600A/2000V的IPM已用于电力机车VVVF逆变器。平面低电感封装技术是大电流IGBT模块为有源器件的PEBB,用于舰艇上的导弹发射装置。IPEM采用共烧瓷片多芯片模块技术组装PEBB,降低电路接线电感。 IGBT模块采用预涂热界面材料(TIM),能让电力电子应用实现一致性的散热性能。

将igbt模块中双极型三极管bjt的集电极和绝缘栅型场效应管mos的漏电极断开,并替代包含镜像电流测试的电路中的取样igbt,从而得到包含无栅极驱动的电流检测的igbt芯片的等效测试电路,即图5中的igbt芯片结构,从而得到第二发射极单元201和第三发射极单元202,此时,bjt的集电极单独引出,即第二发射极单元201,作为测试电流的等效电路,电流检测区域20只取bjt的空穴电流作为检测电流,且,空穴电流与工作区域10的工作电流成比例关系,从而通过检测电流检测区域20中的电流即可得到igbt芯片的工作区域10的电流,避免了现有方法中栅极对地电位变化造成的偏差,提高了检测电流的精度。此外,在第1表面上,电流检测区域20设置在工作区域10的边缘区域,且,电流检测区域20的面积小于工作区域10的面积。此外,igbt芯片为沟槽结构的igbt芯片,在电流检测区域20和工作区域10的对应位置内分别设置多个沟槽,可选的,电流检测区域20和工作区域10可以同时设置有多个沟槽,或者,工作区域10设置有多个沟槽,本发明实施例对此不作限制说明。以及,当设置有沟槽时,在每个沟槽内还填充有多晶硅。此外,在第1表面和第二表面之间,还设置有n型耐压漂移层和导电层。 第1代和第二代采用老命名方式,一般为BSM**GB**DLC或者BSM**GB**DN2。安徽英飞凌infineonIGBT模块工厂直销
第三代IGBT开始,采用新的命名方式。命名的后缀为:T3,E3,P3。四川进口英飞凌infineonIGBT模块服务电话
TC=℃)------通态平均电流VTM=V-----------通态峰值电压VDRM=V-------------断态正向重复峰值电压IDRM=mA-------------断态重复峰值电流VRRM=V-------------反向重复峰值电压IRRM=mA------------反向重复峰值电流IGT=mA------------门极触发电流VGT=V------------门极触发电压执行标准:QB-02-091.晶闸管关断过电压(换流过电压、空穴积蓄效应过电压)及保护晶闸管从导通到阻断,线路电感(主要是变压器漏感LB)释放能量产生过电压。由于晶闸管在导通期间,载流子充满元件内部,在关断过程中,管子在反向作用下,正向电流下降到零时,元件内部残存着载流子。这些载流子在反向电压作用下瞬时出现较大的反向电流,使残存的载流子迅速消失,这时反向电流减小即diG/dt极大,产生的感应电势很大,这个电势与电源串联,反向加在已恢复阻断的元件上,可导致晶闸管反向击穿。这就是关断过电压(换相过电压)。数值可达工作电压的5~6倍。保护措施:在晶闸管两端并接阻容吸收电路。2.交流侧过电压及其保护由于交流侧电路在接通或断开时出现暂态过程,会产生操作过电压。高压合闸的瞬间,由于初次级之间存在分布电容,初级高压经电容耦合到次级,出现瞬时过电压。 四川进口英飞凌infineonIGBT模块服务电话
电压VDS之间加多大或什么极性的电压,总有一个pn结处于反偏状态,漏、源极间没有导电沟道,器件无法导通。但如果VGS正向足够大,此时栅极G和衬底p之间的绝缘层中会产生一个电场,方向从栅极指向衬底,电子在该电场的作用下聚集在栅氧下表面,形成一个N型薄层(一般为几个nm),连通左右两个N+区,形成导通沟道,如图中黄域所示。当VDS>0V时,N-MOSFET管导通,器件工作。了解完以PNP为例的BJT结构和以N-MOSFET为例的MOSFET结构之后,我们再来看IGBT的结构图↓IGBT内部结构及符号黄块表示IGBT导通时形成的沟道。首先看黄色虚线部分,细看之下是不是有一丝熟悉之感?这部分结构和工作...
- 重庆哪里有英飞凌infineonIGBT模块销售 2024-09-10
- 宁夏进口英飞凌infineonIGBT模块销售 2024-09-10
- 四川代理英飞凌infineonIGBT模块联系方式 2024-09-05
- 宁夏进口英飞凌infineonIGBT模块货源充足 2024-09-05
- 山西哪里有英飞凌infineonIGBT模块货源充足 2024-09-05
- 湖南英飞凌infineonIGBT模块厂家电话 2024-09-05
- 河南进口英飞凌infineonIGBT模块 2024-09-05
- 宁夏英飞凌infineonIGBT模块推荐货源 2024-08-10
- 安徽哪里有英飞凌infineonIGBT模块哪里有卖的 2024-08-10
- 河南进口英飞凌infineonIGBT模块联系方式 2024-08-10
- 天津哪里有英飞凌infineonIGBT模块哪里有卖的 2024-08-04
- 北京代理英飞凌infineonIGBT模块厂家电话 2024-08-04
- 陕西代理英飞凌infineonIGBT模块联系方式 2024-08-03
- 辽宁英飞凌infineonIGBT模块 2024-08-03
- 重庆进口英飞凌infineonIGBT模块 2024-08-03
- 安徽代理英飞凌infineonIGBT模块厂家直销 2024-08-03


- 河北哪里有Infineon英飞凌晶闸管模块代理商 09-19
- 浙江进口Infineon英飞凌晶闸管模块哪家好 09-19
- 河北代理西门康SEMIKRON整流桥模块销售 09-19
- 广东哪里有西门康SEMIKRON二极管 09-19
- 重庆哪里有Infineon英飞凌晶闸管联系方式 09-19
- 湖北哪里有Infineon英飞凌二极管厂家电话 09-19
- 河南哪里有Infineon英飞凌晶闸管模块联系方式 09-19
- 上海哪里有Infineon英飞凌晶闸管模块联系方式 09-19
- 广西进口西门康SEMIKRON二极管联系方式 09-19
- 内蒙古进口英飞凌infineonIGBT模块货源充足 09-19







