干涉法与分光光度法都是利用相干光形成等厚干涉条纹的原理来确定薄膜厚度和折射率 ,然而与薄膜自发产生的等倾干涉不同,干涉法是通过设置参考光路,形成与测量光路间的干涉条纹,因此其相位信息包含两个部分,分别是由参考平面和测量平面间扫描高度引起的附加相位和由透明薄膜内部多次反射引起的膜厚相位。干涉法测量光路使用面阵CCD接收参考平面和测量平面间相干波面的干涉光强分布,不同于以上三种点测量方式,可一次性生成薄膜待测区域的表面形貌信息,但同时由于存在大量轴向扫描和数据解算,完成单次测量的时间相对较长。白光干涉膜厚测量技术可以在不同环境下进行测量;高精度膜厚仪供应商
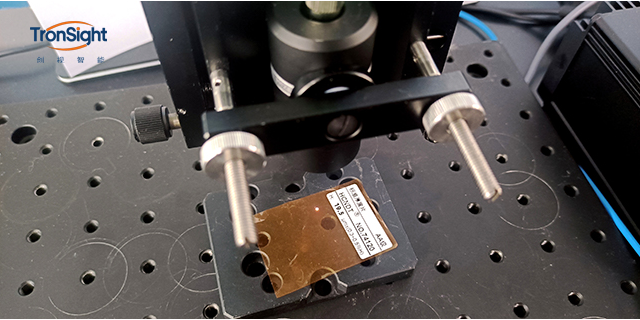
光谱法是以光的干涉效应为基础的一种薄膜厚度测量方法 ,分为反射法和透射法两类[12]。入射光在薄膜-基底-薄膜界面上的反射和透射会引起多光束干涉效应,不同特性的薄膜材料的反射率和透过率曲线是不同的,并且在全光谱范围内与厚度之间是一一对应关系。因此,根据这一光谱特性可以得到薄膜的厚度以及光学参数。光谱法的优点是可以同时测量多个参数且可以有效的排除解的多值性,测量范围广,是一种无损测量技术;缺点是对样品薄膜表面条件的依赖性强,测量稳定性较差,因而测量精度不高;对于不同材料的薄膜需要使用不同波段的光源等。目前,这种方法主要应用于有机薄膜的厚度测量。薄膜膜厚仪供应白光干涉膜厚测量技术可以实现对薄膜的非接触式测量。

白光干涉测量技术,也被称为光学低相干干涉测量技术 ,使用的是低相干的宽谱光源,例如超辐射发光二极管、发光二极管等。同所有的光学干涉原理一样,白光干涉同样是通过观察干涉图样的变化来分析干涉光程差的变化,进而通过各种解调方案实现对待测物理量的测量。采用宽谱光源的优点是由于白光光源的相干长度很小(一般为几微米到几十微米之间),所有波长的零级干涉条纹重合于主极大值,即中心条纹,与零光程差的位置对应。中心零级干涉条纹的存在使测量有了一个可靠的位置的参考值,从而只用一个干涉仪即可实现对被测物理量的测量,克服了传统干涉仪无法实现测量的缺点。同时,相比于其他测量技术,白光干涉测量方法还具有对环境不敏感、抗干扰能力强、测量的动态范围大、结构简单和成本低廉等优点。目前,经过几十年的研究与发展,白光干涉技术在膜厚、压力、温度、应变、位移等等测量领域已经得到广泛的应用。
自上世纪60年代起 ,利用X及β射线、近红外光源开发的在线薄膜测厚系统广泛应用于西方先进国家的工业生产线中。20世纪70年代后,为满足日益增长的质检需求,电涡流、电磁电容、超声波、晶体振荡等多种膜厚测量技术相继问世。90年代中期,随着离子辅助、离子束溅射、磁控溅射、凝胶溶胶等新型薄膜制备技术取得巨大突破,以椭圆偏振法和光度法为展示的光学检测技术以高精度、低成本、轻便环保、高速稳固为研发方向不断迭代更新,迅速占领日用电器及工业生产市场,并发展出依据用户需求个性化定制产品的能力。其中,对于市场份额占比较大的微米级薄膜,除要求测量系统不仅具有百纳米级的测量准确度及分辨力以外,还要求测量系统在存在不规则环境干扰的工业现场下,具备较高的稳定性和抗干扰能力。白光干涉膜厚测量技术可以对薄膜的厚度、反射率、折射率等光学参数进行测量。

论文主要以半导体锗和贵金属金两种材料为对象 ,研究了白光干涉法、表面等离子体共振法和外差干涉法实现纳米级薄膜厚度准确测量的可行性。由于不同材料薄膜的特性不同,所适用的测量方法也不同。半导体锗膜具有折射率高,在通信波段(1550nm附近)不透明的特点,选择采用白光干涉的测量方法;而厚度更薄的金膜的折射率为复数,且能激发的表面等离子体效应,因而可借助基于表面等离子体共振的测量方法;为了进一步改善测量的精度,论文还研究了外差干涉测量法,通过引入高精度的相位解调手段,检测P光与S光之间的相位差提升厚度测量的精度。白光干涉膜厚仪是一种可用于测量薄膜厚度的仪器,适用于透明薄膜和平行表面薄膜的测量。高精度膜厚仪供应商
增加光路长度可以提高仪器分辨率,但同时也会更容易受到振动等干扰,需要采取降噪措施。高精度膜厚仪供应商
在激光惯性约束核聚变实验中 ,靶丸的物性参数和几何参数是靶丸制备工艺改进和仿真模拟核聚变实验过程的基础,因此如何对靶丸多个参数进行同步、高精度、无损的综合检测是激光惯性约束核聚变实验中的关键问题。以上各种薄膜厚度及折射率的测量方法各有利弊,但针对本文实验,仍然无法满足激光核聚变技术对靶丸参数测量的高要求,靶丸参数测量存在以下问题:不能对靶丸进行破坏性切割测量,否则,被破坏后的靶丸无法用于于下一步工艺处理或者打靶实验;需要同时测得靶丸的多个参数,不同参数的单独测量,无法提供靶丸制备和核聚变反应过程中发生的结构变化现象和规律,并且效率低下、没有统一的测量标准。靶丸属于自支撑球形薄膜结构,曲面应力大、难展平的特点导致靶丸与基底不能完全贴合,在微区内可看作类薄膜结构高精度膜厚仪供应商