薄膜材料的厚度在纳米级薄膜的各项相关参数中,是制备和设计中一个重要的参量,也是决定薄膜性质和性能的关键参量之一。然而,由于其极小尺寸及表面效应的影响,纳米级薄膜的厚度准确测量变得困难。科研技术人员通过不断的探索研究,提出了新的薄膜厚度测量理论和技术,并将测量方法从手动到自动、有损到无损等不断改进。对于不同性质的薄膜,其适用的厚度测量方案也不相同。在纳米级薄膜中,采用光学原理的测量技术可以实现精度高、速度快、无损测量等优点,成为主要的检测手段。典型的测量方法包括椭圆偏振法、干涉法、光谱法、棱镜耦合法等。操作需要一定的专业素养和经验,需要进行充分的培训和实践。薄膜检测膜厚仪

光谱法是以光的干涉效应为基础的一种薄膜厚度测量方法 ,分为反射法和透射法两类[12]。入射光在薄膜-基底-薄膜界面上的反射和透射会引起多光束干涉效应,不同特性的薄膜材料的反射率和透过率曲线是不同的,并且在全光谱范围内与厚度之间是一一对应关系。因此,根据这一光谱特性可以得到薄膜的厚度以及光学参数。光谱法的优点是可以同时测量多个参数且可以有效的排除解的多值性,测量范围广,是一种无损测量技术;缺点是对样品薄膜表面条件的依赖性强,测量稳定性较差,因而测量精度不高;对于不同材料的薄膜需要使用不同波段的光源等。目前,这种方法主要应用于有机薄膜的厚度测量。薄膜检测膜厚仪总结,白光干涉膜厚仪是一种应用广、具有高精度和可靠性的薄膜厚度测量仪器。

在初始相位为零的情况下 ,当被测光与参考光之间的光程差为零时,光强度将达到最大值。为探测两个光束之间的零光程差位置,需要精密Z向运动台带动干涉镜头作垂直扫描运动或移动载物台,垂直扫描过程中,用探测器记录下干涉光强,可得白光干涉信号强度与Z向扫描位置(两光束光程差)之间的变化曲线。干涉图像序列中某波长处的白光信号强度随光程差变化示意图,曲线中光强极大值位置即为零光程差位置,通过零过程差位置的精密定位,即可实现样品表面相对位移的精密测量;通过确定最大值对应的Z向位置可获得被测样品表面的三维高度。
靶丸壳层折射率 、厚度及其分布参数是激光惯性约束聚变(ICF)物理实验中非常关键的参数,精密测量靶丸壳层折射率、厚度及其分布对ICF精密物理实验研究具有非常重要的意义。由于靶丸尺寸微小(亚毫米量级)、结构特殊(球形结构)、测量精度要求高,如何实现靶丸壳层折射率及其厚度分布的精密测量是靶参数测量技术研究中重要的研究内容。本论文针对靶丸壳层折射率及厚度分布的精密测量需求,开展了基于白光干涉技术的靶丸壳层折射率及厚度分布测量技术研究。白光干涉膜厚测量技术可以应用于光学元件制造中的薄膜厚度控制;
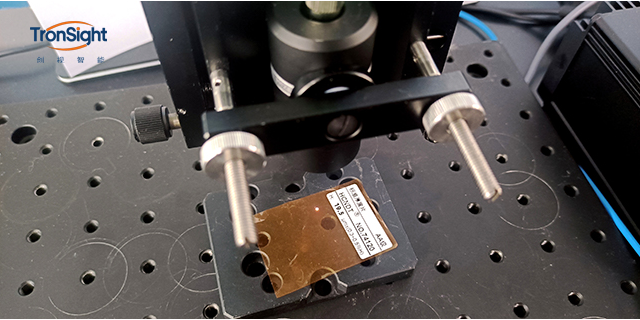
利用包络线法计算薄膜的光学常数和厚度 ,但目前看来包络法还存在很多不足,包络线法需要产生干涉波动,要求在测量波段内存在多个干涉极值点,且干涉极值点足够多,精度才高。理想的包络线是根据联合透射曲线的切点建立的,在没有正确方法建立包络线时,通常使用抛物线插值法建立,这样造成的误差较大。包络法对测量对象要求高,如果薄膜较薄或厚度不足情况下,会造成干涉条纹减少,干涉波峰个数较少,要利用干涉极值点建立包络线就越困难,且利用抛物线插值法拟合也很困难,从而降低该方法的准确度。其次,薄膜吸收的强弱也会影响该方法的准确度,对于吸收较强的薄膜,随干涉条纹减少,极大值与极小值包络线逐渐汇聚成一条曲线,该方法就不再适用。因此,包络法适用于膜层较厚且弱吸收的样品。高精度的白光干涉膜厚仪通常采用Michelson干涉仪的结构。纳米级膜厚仪推荐
白光干涉膜厚测量技术的优化需要对实验方法和算法进行改进。薄膜检测膜厚仪
光学测厚方法结合了光学、机械、电子和计算机图像处理技术,以光波长为测量基准,从原理上保证了纳米级的测量精度。由于光学测厚是非接触式的测量方法,因此被用于精密元件表面形貌及厚度的无损测量。针对薄膜厚度的光学测量方法,可以按照光吸收、透反射、偏振和干涉等不同光学原理分为分光光度法、椭圆偏振法、干涉法等多种测量方法。不同的测量方法各有优缺点和适用范围。因此,有一些研究采用了多通道式复合测量法,结合多种测量方法,例如椭圆偏振法和光度法结合的光谱椭偏法,彩色共焦光谱干涉和白光显微干涉的结合法等。薄膜检测膜厚仪